氮化鎵因為具備出色的電子遷移率、高崩潰電壓,以及高頻、高功率運作的能力而特別突出。基於氮化鎵的裝置由於具備優異的熱穩定性和效率,為射頻與微波應用的首選;這些應用包含5G基礎建設、雷達和衛星通訊。然而,High-k材料的缺陷,會對這些元件的特性與運作造成重大影響,本文將介紹一項imec針對功率放大器進行的矽上氮化鎵可靠度研究主要成果。
自1980年代以來,無線傳輸技術經歷數次演變,以滿足應用對傳輸速度與可靠度的要求。然而,應用對資料傳輸頻寬的爆炸式增長不僅未見減緩,甚至還隨著整合人工智慧(AI)與虛擬實境的需求而進一步加速成長。因此,業界必須設法開拓新的通訊頻段,例如6GHz以上的毫米波頻段,才能滿足未來的應用需求。
目前,5G主要在6GHz以下的頻段運行,提供超越以往的資料傳輸率、超低延遲,以及同時連接大量裝置的能力。這為智慧城市、自駕車及物聯網(IoT)等新興應用提供發展條件。其所使用的射頻(RF)元件,主要是基於絕緣層上覆矽(SOI)技術。然而,由於矽材料在速度方面存在根本性的限制,以三五族材料為基礎的元件,將會取代矽基材料,作為新一代射頻技術的主要根基。
這些具備發展潛力的材料有矽鍺(SiGe)、磷化銦(InP)及氮化鎵(GaN),其中氮化鎵因為具備出色的電子遷移率、高崩潰電壓,以及高頻、高功率運作的能力而特別突出。基於氮化鎵的裝置由於具備優異的熱穩定性和效率,為射頻與微波應用的首選;這些應用包含5G基礎建設、雷達和衛星通訊。
基於矽上氮化鎵技術的MOS-HEMT
比利時微電子研究中心(imec)的研究人員目前正在探索運行在FR3頻段(約為7~25 GHz)的矽上氮化鎵(GaN-on-Silicon)技術,並試圖製作出基於這項材料的毫米波功率放大器。
在毫米波頻段運作的氮化鎵功率放大器展現優於其他技術的超高輸出功率,而且製造於矽材上時,這些元件還提供成本方面的附加優勢。鋁氮化鎵(AlGaN)/氮化鎵(GaN)高電子遷移率電晶體(HEMT)具備絕佳的高頻性能和處理高功率的能力,可用來作為這些放大器的核心電晶體。
為根據5G及其後續應用來最佳化射頻電晶體的性能,橫向微縮(縮小電晶體的寬度和長度)及垂直微縮(調整元件層的厚度)皆不可或缺。橫向微縮可以提升速度和頻率響應,而垂直微縮則是管理短通道效應(會使得電晶體性能衰退)所必須實現的目標。然而,持續的垂直微縮也可能導致漏電流增加,尤其是在電晶體處於導通狀態時。緩減這種效應的一種途徑,是採用金屬氧化物半導體(MOS) HEMT結構,在閘極金屬和鋁氮化鎵阻障層之間插入一層高介電(High-K)材料。
過去20年來,高介電材料已廣泛用於先進矽製程,其原因就是為了減少超小型電晶體內的漏電。然而,高介電材料的缺陷問題相當嚴重。要克服將這些材料結合到矽基邏輯元件所面臨的可靠度挑戰,需要研究高介電材料在這些MOS-HEMT結構(圖1)中產生的影響。
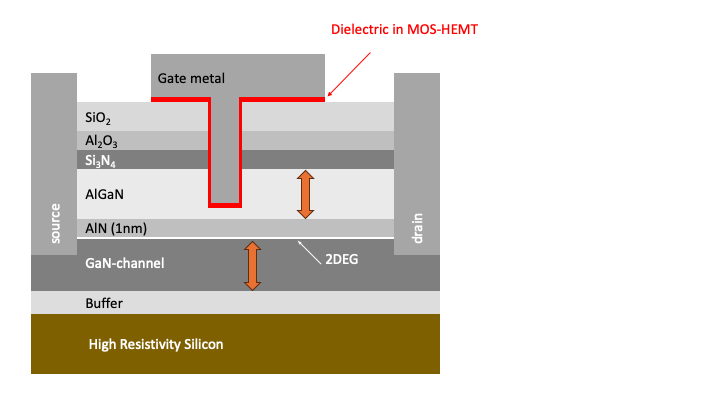 圖1 MOS-HEMT元件的概略設計,包含沉積在部分蝕刻的鋁氮化鎵層內之閘極介電層
圖1 MOS-HEMT元件的概略設計,包含沉積在部分蝕刻的鋁氮化鎵層內之閘極介電層
本文將介紹一項imec針對功率放大器進行的矽上氮化鎵可靠度研究主要成果。該研究成果已在2024年IEEE國際可靠性物理研討會(IRPS)上發表,並收錄於其會議論文集。在這項研究中,imec團隊不僅展示了採用高介電材料的HEMT結構內的電荷捕捉和電荷發射,更找出其重大缺陷的實際位置和能階位置。
當元件內的電荷載子受限於半導體或介電材料內的特定缺陷,或是從中釋出時,會發生電荷捕捉與發射。此現象會影響HEMT的性能與可靠度,尤其是在高頻與高功率應用中。此研究結果將協助我們為這些元件的製程定義出最佳化的材料組合和元件層厚度。
從MOS-HEMT內部的介電塊材有效捕捉電子
影響MOS-HEMT的一大可靠度問題是偏壓溫度不穩定性(BTI),這是指電晶體在特定溫度狀況下,因長期暴露於電應力(偏壓)而逐漸衰退的現象。其原因是介電層內部或是介電層與半導體層之間的介面出現電子捕捉。偏壓溫度不穩定性造成臨界電壓(Vt)逐漸偏移,這意味著電晶體需要更高的電壓來啟動,導致電路的速度和效率降低。
imec研究人員對包含二氧化鉿(HfO2)或氧化鋁(Al2O3)高介電材料的MOSHEMT元件施加直流電壓或「應力」來偏壓溫度不穩定性,並監測其臨界電壓。在氧化鋁堆疊方面,臨界電壓會隨著時間和偏壓而升高,這代表在大範圍的偏壓和能量範圍下可能出現的缺陷。二氧化鉿則發現兩種衰退模式:在較低的電壓下,結果顯示出類似於HEMT且與時間無關的極低電荷捕捉現象,但在較高應力偏壓的情況下, 可以觀察到明顯的臨界電壓偏移, 且隨著時間和偏壓呈現指數增長, 直到大約300mV而達到飽和狀態。這種與偏壓呈現高度相依的特性表示,在該偏壓範圍內,存在一種相對狹窄的缺陷類型(圖2)。
 圖2 包含二氧化鉿(HfO2)或氧化鋁(Al2O3)高介電材料層的MOS-HEMT結構所展現的電荷捕捉特性。包含氧化鋁(Al2O3)的元件顯示隨著時間和偏壓而增加的臨界電壓,代表在廣泛的能階範圍內出現的缺陷類型。二氧化鉿(HfO2)元件則在低偏壓狀態下展示低到可忽略的電荷捕捉現象,但在較高偏壓下出現明顯的臨界電壓偏移。這可能代表在該偏壓範圍內的一種相對狹窄的缺陷類型
圖2 包含二氧化鉿(HfO2)或氧化鋁(Al2O3)高介電材料層的MOS-HEMT結構所展現的電荷捕捉特性。包含氧化鋁(Al2O3)的元件顯示隨著時間和偏壓而增加的臨界電壓,代表在廣泛的能階範圍內出現的缺陷類型。二氧化鉿(HfO2)元件則在低偏壓狀態下展示低到可忽略的電荷捕捉現象,但在較高偏壓下出現明顯的臨界電壓偏移。這可能代表在該偏壓範圍內的一種相對狹窄的缺陷類型
這些電荷是陷落在介電塊材還是介面內呢?研究人員能透過觀察臨界電壓偏移對高介電材料層厚度的反應、電容測量和模擬結果來分辨這兩種電荷捕捉的位置。他們發現大多數的電荷捕捉發生在介電塊材內。
二氧化鉿MOS-HEMT存在三種缺陷類型
當應力關閉時,陷落電荷可能獲得釋放或發射。分析電荷發射的動力學,可得到有關元件可靠度(Vt的回復)及缺陷來源的資訊。結果顯示,造成氧化鋁內部出現臨界電壓偏移的缺陷快速且完全釋出其電荷,而二氧化鉿元件的電荷發射則較慢發生,且持續處於未完全釋放狀態,意味著另一種缺陷。
為測定究竟出現了多少種缺陷,上述的實驗結果被套用到通用的應力鬆弛模型。這套模型假設每種缺陷各自都有遵循特定分配方式的特徵能量。把這套模型套用到二氧化鉿元件,資料清楚顯示有超過一種的缺陷能階在發揮作用,因為電荷發射資料與該模型並不相符。
該模擬僅考量那些顯現完全電荷發射(臨界電壓已經回復)的缺陷,但在部分狀況下,陷落電荷並沒有從缺陷中射出(臨界電壓的變化呈現永久性)。把該永久性的組成部分添入上述模型,模型與二氧化鉿元件的資料較能吻合,但仍不完美。雖然差距只有10mV,但結果顯示,共有三種不同的缺陷類型出現在二氧化鉿MOS-HEMT元件內。
另一方面,有關氧化鋁介電材料的文獻研究先前指出只有兩種會造成電荷捕捉的缺陷類型。然而,氧化鋁內部的缺陷分布廣泛,使得更細部的分析變得複雜(圖3)。
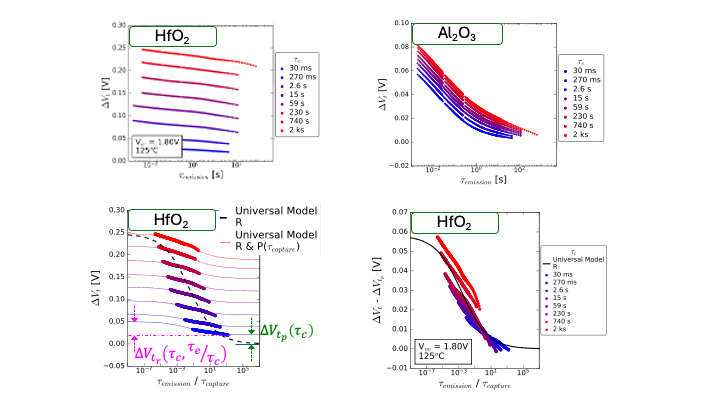 圖3 二氧化鉿MOS-HEMT(左)與氧化鋁MOS-HEMT(右)隨著時間增加而出現應力的電荷發射動力學(上)。需留意氧化鋁和二氧化鉿之間的發射表現差異,後者只有部分發射。下半部圖表將上述資料套用到通用的應力鬆弛模型,顯示二氧化鉿的發射現象包含(左)可回復部分、(右)永久性部分及第三部分,因為這些資料與模型並不完全吻合
圖3 二氧化鉿MOS-HEMT(左)與氧化鋁MOS-HEMT(右)隨著時間增加而出現應力的電荷發射動力學(上)。需留意氧化鋁和二氧化鉿之間的發射表現差異,後者只有部分發射。下半部圖表將上述資料套用到通用的應力鬆弛模型,顯示二氧化鉿的發射現象包含(左)可回復部分、(右)永久性部分及第三部分,因為這些資料與模型並不完全吻合
識別及定位二氧化鉿元件內部缺陷
下一步,這些研究人員調查了這些缺陷怎麼導致臨界電壓偏移,為元件可靠度提供深入看法。他們透過計算缺陷用來捕捉和釋放電荷所需的活化能,成功為二氧化鉿標出三種不同的缺陷類型。一種低熱能活化的缺陷(R1)會快速捕獲和發射電子,而其他兩種具備較高活化能的缺陷(R2與R3)則具備相似的電荷捕捉速率,但會以不同的方式發射電荷。
能帶圖(圖4) 顯示, 施加偏壓電壓時,電子被捕捉到介電層內的淺層缺陷,落在二氧化鉿的導帶下方約2eV。這種缺陷能階在低應力偏壓下無法達到所需能量,這解釋了電荷捕捉在高壓狀態下較為顯著的原因,而且這個過程取決於施加的偏壓大小。
 圖4 左圖為二氧化鉿MOS-HEMT活化能帶圖。該圖顯示,建模後用來解釋測得的偏壓溫度不穩定性(BTI)之三種缺陷類型;右圖為模擬的二氧化鉿MOS-HEMT能帶圖。該圖顯示從三種缺陷類型進行電子捕捉和發射時,用來填補淺層缺陷的電子。來自淺層缺陷的電子可能發射到通道(可回復)或是發射到鋁氮化鎵導帶(不可回復),同時二氧化鉿深層能階可以獲得電荷,解釋了低溫狀態下觀察到逐漸增加的臨界電壓
圖4 左圖為二氧化鉿MOS-HEMT活化能帶圖。該圖顯示,建模後用來解釋測得的偏壓溫度不穩定性(BTI)之三種缺陷類型;右圖為模擬的二氧化鉿MOS-HEMT能帶圖。該圖顯示從三種缺陷類型進行電子捕捉和發射時,用來填補淺層缺陷的電子。來自淺層缺陷的電子可能發射到通道(可回復)或是發射到鋁氮化鎵導帶(不可回復),同時二氧化鉿深層能階可以獲得電荷,解釋了低溫狀態下觀察到逐漸增加的臨界電壓
移除偏壓時,能帶圖也能協助解釋為什麼有些已捕獲的電子被發射回氮化鎵通道內,產生一種可回復的臨界電壓偏移(R2)。但其他電子仍然陷落在二氧化鉿層和鋁氮化鎵層之間的能障內,導致一種永久性的臨界電壓偏移(R3)。這種不同的電荷發射表現顯示,雖然都是由相同類型的缺陷造成,但由於這兩種發射路徑,所以需要當作兩種缺陷進行建模。另外,研究團隊也識別出一種更深層的缺陷(約在導帶下方3eV),導致負臨界電壓偏移(R1),因為這些陷落電子在回復期間流失。
發展更可靠的增強型MOSHEMT元件
這項研究為理解二氧化鉿和氧化鋁等不同的高介電材料如何影響MOSHEMT元件的性能和可靠度,提供了非常重要的見解。在二氧化鉿內部識別出多種缺陷類型,包含不同的電荷捕捉和發射特性,突顯了這種材料在電應力下不同的反應方式。
氧化鋁具備較快速的電荷回復能力,對需要快速開關的應用來說,可能提供更佳的穩定度,而二氧化鉿因為發射速度較慢,而展現更持久的臨界電壓偏移,這可能會影響元件的長期可靠度。此外,二氧化鉿具備更高的缺陷密度,但這些缺陷的能階分布在較窄的能量範圍,而氧化鋁具備較低的缺陷密度,但這些重大缺陷分散在較廣的能量範圍。這些研究結果對於最佳化高頻和高功率元件內的材料組合和元件層厚度,具備特殊意義,可以被用來在各式應用中,實現性能與耐久性更加平衡的改良版設計。
接下來,這些研究結果仍要與增強型(e-mode,即臨界電壓>0V)的MOSHEMT元件進行比較。雖然HEMT結構本身為空乏型(d-mode,元件在0V時開啟),但是射頻應用偏好使用增強型,因為增強型能夠降低功耗並提升可靠度。
除此之外,增強型元件可簡化電路設計,無需使用那些透過產生負電壓來關閉空乏型電晶體的電壓移位器,也無需用來避免空乏型元件短路和功率突增的多步驟元件啟動。最後,包含這些介電材料層的MOS-HEMT射頻性能以及缺陷能階之間的互動,仍有待進一步研究。
(本文作者任職於imec)